Walaupun kedua-dua wafer silikon dan kaca berkongsi matlamat yang sama untuk "dibersihkan," cabaran dan mod kegagalan yang dihadapinya semasa pembersihan adalah sangat berbeza. Perbezaan ini timbul daripada sifat bahan yang wujud dan keperluan spesifikasi silikon dan kaca, serta "falsafah" pembersihan yang berbeza yang didorong oleh aplikasi akhir mereka.
Pertama sekali, mari kita jelaskan: Apakah sebenarnya yang kita bersihkan? Apakah bahan cemar yang terlibat?
Bahan pencemar boleh dikelaskan kepada empat kategori:
-
Bahan Pencemar Zarah
-
Habuk, zarah logam, zarah organik, zarah kasar (daripada proses CMP), dsb.
-
Bahan cemar ini boleh menyebabkan kecacatan corak, seperti litar pintas atau litar terbuka.
-
-
Bahan Pencemar Organik
-
Termasuk sisa fotoresis, bahan tambahan resin, minyak kulit manusia, sisa pelarut, dsb.
-
Bahan cemar organik boleh membentuk topeng yang menghalang pengetsaan atau implantasi ion dan mengurangkan lekatan filem nipis yang lain.
-
-
Bahan Pencemar Ion Logam
-
Besi, kuprum, natrium, kalium, kalsium, dan sebagainya, yang terutamanya berasal daripada peralatan, bahan kimia dan sentuhan manusia.
-
Dalam semikonduktor, ion logam merupakan bahan cemar "pembunuh", memperkenalkan tahap tenaga dalam jalur terlarang, yang meningkatkan arus bocor, memendekkan jangka hayat pembawa dan merosakkan sifat elektrik dengan teruk. Dalam kaca, ia boleh menjejaskan kualiti dan lekatan filem nipis berikutnya.
-
-
Lapisan Oksida Asli
-
Untuk wafer silikon: Lapisan nipis silikon dioksida (Oksida Asli) terbentuk secara semula jadi di permukaan udara. Ketebalan dan keseragaman lapisan oksida ini sukar dikawal, dan ia mesti disingkirkan sepenuhnya semasa fabrikasi struktur utama seperti oksida pintu.
-
Untuk wafer kaca: Kaca itu sendiri ialah struktur rangkaian silika, jadi tiada isu untuk "menyingkirkan lapisan oksida asli". Walau bagaimanapun, permukaannya mungkin telah diubah suai disebabkan oleh pencemaran, dan lapisan ini perlu disingkirkan.
-

I. Matlamat Teras: Perbezaan Antara Prestasi Elektrik dan Kesempurnaan Fizikal
-
Wafer Silikon
-
Matlamat utama pembersihan adalah untuk memastikan prestasi elektrik. Spesifikasi biasanya merangkumi kiraan dan saiz zarah yang ketat (contohnya, zarah ≥0.1μm mesti disingkirkan dengan berkesan), kepekatan ion logam (contohnya, Fe, Cu mesti dikawal kepada ≤10¹⁰ atom/cm² atau lebih rendah), dan tahap sisa organik. Malah pencemaran mikroskopik boleh menyebabkan litar pintas, arus kebocoran atau kegagalan integriti oksida pintu.
-
-
Wafer Kaca
-
Sebagai substrat, keperluan terasnya adalah kesempurnaan fizikal dan kestabilan kimia. Spesifikasi memberi tumpuan kepada aspek peringkat makro seperti ketiadaan calar, kesan yang tidak boleh ditanggalkan, dan pengekalan kekasaran permukaan dan geometri asal. Matlamat pembersihan adalah terutamanya untuk memastikan kebersihan visual dan lekatan yang baik untuk proses seterusnya seperti salutan.
-
II. Sifat Bahan: Perbezaan Asas Antara Kristal dan Amorf
-
Silikon
-
Silikon ialah bahan kristal, dan permukaannya secara semula jadi menumbuhkan lapisan oksida silikon dioksida (SiO₂) yang tidak seragam. Lapisan oksida ini menimbulkan risiko kepada prestasi elektrik dan mesti disingkirkan secara menyeluruh dan seragam.
-
-
Kaca
-
Kaca ialah rangkaian silika amorfus. Bahan pukalnya mempunyai komposisi yang serupa dengan lapisan silikon oksida silikon, yang bermaksud ia boleh diukir dengan cepat oleh asid hidrofluorik (HF) dan juga mudah terdedah kepada hakisan alkali yang kuat, yang membawa kepada peningkatan kekasaran permukaan atau ubah bentuk. Perbezaan asas ini menentukan bahawa pembersihan wafer silikon boleh bertolak ansur dengan cahaya, pengukiran terkawal untuk menghilangkan bahan cemar, manakala pembersihan wafer kaca mesti dilakukan dengan sangat berhati-hati untuk mengelakkan kerosakan pada bahan asas.
-
| Barang Pembersihan | Pembersihan Wafer Silikon | Pembersihan Wafer Kaca |
|---|---|---|
| Matlamat Pembersihan | Termasuk lapisan oksida aslinya sendiri | Pilih kaedah pembersihan: Buang bahan cemar sambil melindungi bahan asas |
| Pembersihan RCA Standard | - SPM(H₂SO₄/H₂O₂): Menghilangkan sisa organik/fotoresis | Aliran Pembersihan Utama: |
| - SC1(NH₄OH/H₂O₂/H₂O): Menghilangkan zarah permukaan | Agen Pembersih Alkali LemahMengandungi agen permukaan aktif untuk menyingkirkan bahan cemar dan zarah organik | |
| - DHF(Asid hidrofluorik): Menghilangkan lapisan oksida semula jadi dan bahan cemar lain | Agen Pembersih Alkali atau Alkali Tengah yang KuatDigunakan untuk membuang bahan cemar logam atau tidak meruap | |
| - SC2(HCl/H₂O₂/H₂O): Menghilangkan bahan cemar logam | Elakkan HF sepanjang masa | |
| Bahan Kimia Utama | Asid kuat, alkali kuat, pelarut pengoksidaan | Agen pembersih alkali lemah, dirumus khas untuk penyingkiran pencemaran ringan |
| Alat Bantu Fizikal | Air ternyahion (untuk pembilasan berketulenan tinggi) | Pencucian ultrasonik, megasonik |
| Teknologi Pengeringan | Pengeringan wap Megasonik, IPA | Pengeringan lembut: Angkat perlahan, pengeringan wap IPA |
III. Perbandingan Larutan Pembersihan
Berdasarkan matlamat dan ciri-ciri bahan yang dinyatakan di atas, larutan pembersih untuk wafer silikon dan kaca berbeza:
| Pembersihan Wafer Silikon | Pembersihan Wafer Kaca | |
|---|---|---|
| Objektif pembersihan | Penyingkiran menyeluruh, termasuk lapisan oksida asli wafer. | Penyingkiran terpilih: menghapuskan bahan cemar sambil melindungi substrat. |
| Proses tipikal | Pembersihan RCA standard:•SPM(H₂SO₄/H₂O₂): menyingkirkan bahan organik berat/fotoresis •SC1(NH₄OH/H₂O₂/H₂O): penyingkiran zarah alkali •DHF(HF cair): menanggalkan lapisan oksida asli dan logam •SC2(HCl/H₂O₂/H₂O): menyingkirkan ion logam | Aliran pembersihan ciri:•Pencuci alkali ringandengan surfaktan untuk menyingkirkan bahan organik dan zarah •Pencuci berasid atau neutraluntuk menyingkirkan ion logam dan bahan cemar khusus yang lain •Elakkan HF sepanjang proses |
| Bahan kimia utama | Asid kuat, pengoksida kuat, larutan alkali | Pencuci alkali ringan; pembersih neutral atau sedikit berasid khusus |
| Bantuan fizikal | Megasonik (penyingkiran zarah yang cekap dan lembut) | Ultrasonik, megasonik |
| Pengeringan | pengeringan Marangoni; Pengeringan wap IPA | Pengeringan tarik perlahan; Pengeringan wap IPA |
-
Proses Pembersihan Wafer Kaca
-
Pada masa ini, kebanyakan loji pemprosesan kaca menggunakan prosedur pembersihan berdasarkan ciri-ciri bahan kaca, bergantung terutamanya pada agen pembersih alkali yang lemah.
-
Ciri-ciri Agen Pembersih:Agen pembersih khusus ini biasanya beralkali lemah, dengan pH sekitar 8-9. Ia biasanya mengandungi surfaktan (contohnya, alkil polioksietilena eter), agen pengkelat logam (contohnya, HEDP) dan alat pembersih organik, yang direka untuk mengemulsi dan menguraikan bahan cemar organik seperti minyak dan cap jari, sambil menghakis matriks kaca dengan minimum.
-
Aliran Proses:Proses pembersihan biasa melibatkan penggunaan agen pembersih alkali lemah dengan kepekatan tertentu pada suhu antara suhu bilik hingga 60°C, digabungkan dengan pembersihan ultrasonik. Selepas pembersihan, wafer menjalani pelbagai langkah pembilasan dengan air tulen dan pengeringan lembut (contohnya, pengangkatan perlahan atau pengeringan wap IPA). Proses ini berkesan memenuhi keperluan wafer kaca untuk kebersihan visual dan kebersihan umum.
-
-
Proses Pembersihan Wafer Silikon
-
Untuk pemprosesan semikonduktor, wafer silikon biasanya menjalani pembersihan RCA standard, yang merupakan kaedah pembersihan yang sangat berkesan yang mampu menangani semua jenis bahan cemar secara sistematik, memastikan keperluan prestasi elektrik untuk peranti semikonduktor dipenuhi.
-
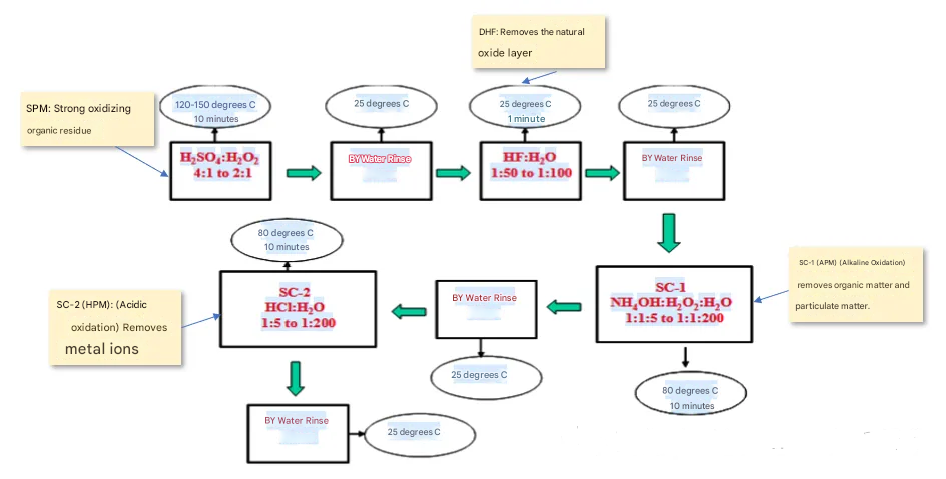
IV. Apabila Kaca Memenuhi Piawaian "Kebersihan" yang Lebih Tinggi
Apabila wafer kaca digunakan dalam aplikasi yang memerlukan kiraan zarah dan tahap ion logam yang ketat (contohnya, sebagai substrat dalam proses semikonduktor atau untuk permukaan pemendapan filem nipis yang sangat baik), proses pembersihan intrinsik mungkin tidak lagi mencukupi. Dalam kes ini, prinsip pembersihan semikonduktor boleh digunakan, memperkenalkan strategi pembersihan RCA yang diubah suai.
Teras strategi ini adalah untuk mencairkan dan mengoptimumkan parameter proses RCA standard bagi menampung sifat sensitif kaca:
-
Penyingkiran Bahan Pencemar Organik:Larutan SPM atau air ozon yang lebih lembut boleh digunakan untuk menguraikan bahan cemar organik melalui pengoksidaan yang kuat.
-
Penyingkiran Zarah:Larutan SC1 yang sangat cair digunakan pada suhu yang lebih rendah dan masa rawatan yang lebih singkat untuk memanfaatkan kesan tolakan elektrostatik dan mikro-pengetsaannya bagi menyingkirkan zarah, sambil meminimumkan kakisan pada kaca.
-
Penyingkiran Ion Logam:Larutan SC2 yang dicairkan atau larutan asid hidroklorik cair/asid nitrik cair yang ringkas digunakan untuk menyingkirkan bahan cemar logam melalui pengkelat.
-
Larangan Ketat:DHF (di-ammonium fluorida) mesti dielakkan sepenuhnya untuk mencegah kakisan pada substrat kaca.
Dalam keseluruhan proses yang diubah suai, menggabungkan teknologi megasonik meningkatkan kecekapan penyingkiran zarah bersaiz nano dengan ketara dan lebih lembut di permukaan.
Kesimpulan
Proses pembersihan untuk wafer silikon dan kaca adalah hasil yang tidak dapat dielakkan daripada kejuruteraan terbalik berdasarkan keperluan aplikasi akhir, sifat bahan dan ciri fizikal dan kimia. Pembersihan wafer silikon bertujuan untuk mencapai "kebersihan peringkat atom" untuk prestasi elektrik, manakala pembersihan wafer kaca memberi tumpuan kepada mencapai permukaan fizikal yang "sempurna dan tidak rosak". Memandangkan wafer kaca semakin banyak digunakan dalam aplikasi semikonduktor, proses pembersihannya pasti akan berkembang melangkaui pembersihan alkali lemah tradisional, membangunkan penyelesaian yang lebih halus dan tersuai seperti proses RCA yang diubah suai untuk memenuhi piawaian kebersihan yang lebih tinggi.
Masa siaran: 29 Okt-2025
